Fokussierter Ionenstrahl

Mit der zunehmenden Bedeutung der Nanotechnologie sind sowohl analytische als auch präparative Werkzeuge gefragt, die auf solche Längenskalen optimiert sind. Ein vielseitiges Instrument in diesem Sinne ist der fokussierte Ionenstrahl. Bei diesem Instrument wird ein Ionenstrahl auf die Oberfläche fokussiert und rasterförmig bewegt. Dies ermöglicht das Abtragen von Material durch Ionenzerstäubung ("Fräsen") mit einer Auflösung von ≈ 10 nm. Das FEI Nova 600 Nanolab FIB-Instrument am MPIP ist ein sogenanntes Zweistrahlinstrument, das einen fokussierten Ionenstrahl mit einem Rasterelektronenmikroskop (REM) kombiniert, das eine simulatane Abbildung der Probe ermöglicht. Diese Kombination ist besonders wichtig für die Präparation empfindlicher Proben, bei denen die Probenausrichtung unter REM-Kontrolle ohne die Notwendigkeit einer Ionenstrahlabbildung erfolgt. Unser System ist mit 3 Gasinjektionssystemen ausgestattet, die für die ionenstrahlinduzierte Materialabscheidung von Pt-, Au- oder SiO2-Schichten verwendet werden können. Weitere Optionen sind ein EDX-Detektor zur Elementaranalyse, ein Nanomanipulator zum Ausheben der TEM-Lamelle (siehe unten) und ein Kryo-System für Untersuchungen an "nassen" Proben wie Zellen oder Hydrogelen bei Temperaturen bis -140°C. Die Hauptanwendungen des FIB am MPI-P sind die Nanostrukturierung von Oberflächen, Querschnitte von Proben, Präparation, TEM-Probenpräparation und Cryo-SEM. Die Hauptanwendung der FIB am MPI-P ist die Nanostrukturierung von Oberflächen. Abb. 1 zeigt Beispiele von Nanostrukturen, die durch FIB-Strukturierung hergestellt werden.
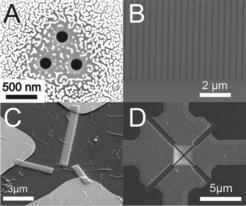
Wo FIB völlig neue Möglichkeiten eröffnet, ist die Präparation von TEM-Lamellen, d.h. die ortsspezifische Präparation von ~50 nm dünnen Scheiben aus größeren Probenkörpern, die auf andere Weise kaum oder gar nicht zugänglich sind. Abb. 2 zeigt den ersten Schritt bei der Präparation einer TEM-Lamelle aus einem Pixel eines OLED-Displays. Die Lamelle, die den interessierenden Bereich enthält, ist bereits freigelegt, muss aber noch mit FIB ausgeschnitten und mit dem Nanomanipulator herausgehoben und auf einen TEM Probenhalter übertragen werden.
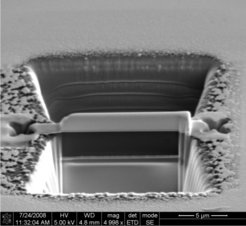
Mit dem sogenannten "Slice and View"-Protokoll ist eine 3D-Tomographie von Proben möglich. In diesem Modus werden durch Ionenstrahlsputtern von einem kleinen Block der Probe Scheiben von typischerweise 10-100 nm Dicke entfernt. Nach jeder Scheibe wird ein REM-Bild der neu belichteten Probenfläche aufgenommen (Abb. 3). Aus einem solchen Satz von Schichtbildern kann durch Bildanalyse eine 3D-Rekonstruktion der Probe gewonnen werden.